Imec und ASML kooperieren bei 3-nm-Lithographie
5. November 2018
über
über
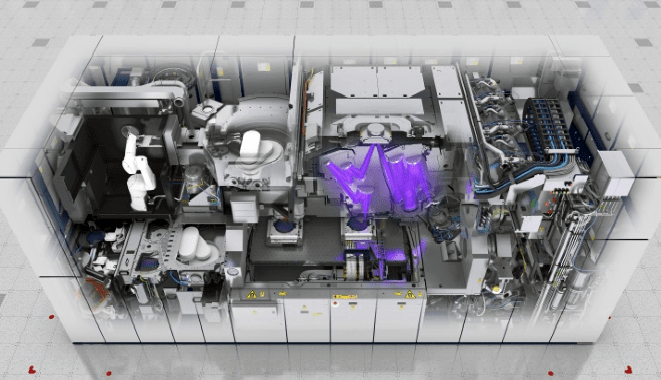
Die Forschungseinrichtung Imec und der Hersteller von Lithographiegeräten ASML wollen ein gemeinsames Labor zur Forschung an der Herstellungstechnik von Halbleitern mit Strukturen von 3 nm.
Beide Partner arbeiten schon seit fast 30 Jahren zusammen und planen jetzt eine zweiphasige Kooperation. In der ersten Phase geht es um EUV-Lithographie für die Massenproduktion samt entsprechender EUV-Produktionstechnik. In der zweiten Phase wird EUV-Lithographie mit hoher numerischer Apertur der nächsten Generation untersucht, um Halbleiterstrukturen im Bereich von 3 nm zu ermöglichen.
Zunächst wird für die erste Phase der EUV-Scanner NXE:3400B von ASML in Imecs Reinraum installiert und die aktuelle 0.33-NA-EUV-Lithographietechnik weiterentwickelt. Das EUV-System operiert mit einer 250-W-Lichtquelle und erlaubt einen Durchsatz von mehr als 125 Wafern/Stunde. Das bei Imec installierte System wird mit neuester Nivelliersensorik ausgestattet, um einen hohen Durchsatz bei optimaler Prozesskontrolle zu erreichen und die Anpassung an den neuesten Tauchscanner NXT:2000i zu erleichtern, der dort nächstes Jahr installiert wird.
Im Rahmen der zweiten Phase werden die Partner ein HighNA-EUV-Forschungslabor einrichten, in dem mit EUV-Lithographie der nächsten Generation bei höherer NA experimentieren wird. Diese projizieren das EUV-Licht unter größeren Winkeln, was die Auflösung verbessert und die Belichtung kleinerer Strukturen erlaubt. Das neue System HighNA EUV EXE:5000 hat eine NA von 0,55 statt den 0,33 bei NXE:3400.
Das System EXE:5000 soll bis 2021 fertig sein. Mit ihm soll auf die Herausforderungen bei Systemen für die Belichtung bei 3 nm reagiert werden. Diese Technologie dürfte schon an die Grenzen des Machbaren gehen, wenn man den Silizium-Gitterabstand von lediglich 0,543 nm bedenkt.
Beide Partner arbeiten schon seit fast 30 Jahren zusammen und planen jetzt eine zweiphasige Kooperation. In der ersten Phase geht es um EUV-Lithographie für die Massenproduktion samt entsprechender EUV-Produktionstechnik. In der zweiten Phase wird EUV-Lithographie mit hoher numerischer Apertur der nächsten Generation untersucht, um Halbleiterstrukturen im Bereich von 3 nm zu ermöglichen.
Zunächst wird für die erste Phase der EUV-Scanner NXE:3400B von ASML in Imecs Reinraum installiert und die aktuelle 0.33-NA-EUV-Lithographietechnik weiterentwickelt. Das EUV-System operiert mit einer 250-W-Lichtquelle und erlaubt einen Durchsatz von mehr als 125 Wafern/Stunde. Das bei Imec installierte System wird mit neuester Nivelliersensorik ausgestattet, um einen hohen Durchsatz bei optimaler Prozesskontrolle zu erreichen und die Anpassung an den neuesten Tauchscanner NXT:2000i zu erleichtern, der dort nächstes Jahr installiert wird.
Im Rahmen der zweiten Phase werden die Partner ein HighNA-EUV-Forschungslabor einrichten, in dem mit EUV-Lithographie der nächsten Generation bei höherer NA experimentieren wird. Diese projizieren das EUV-Licht unter größeren Winkeln, was die Auflösung verbessert und die Belichtung kleinerer Strukturen erlaubt. Das neue System HighNA EUV EXE:5000 hat eine NA von 0,55 statt den 0,33 bei NXE:3400.
Das System EXE:5000 soll bis 2021 fertig sein. Mit ihm soll auf die Herausforderungen bei Systemen für die Belichtung bei 3 nm reagiert werden. Diese Technologie dürfte schon an die Grenzen des Machbaren gehen, wenn man den Silizium-Gitterabstand von lediglich 0,543 nm bedenkt.
Mehr anzeigen
Weniger anzeigen


Diskussion (0 Kommentare)